С середины года циркулируют некоторые слухи, что свежие микропроцессоры для телефонов Эпл Айфон 7 будут базироваться на 16-нм процесс TSMC и вид упаковки Fan-Out Wafer Level Package (FO-WLP). Тщательно про это мы говорили в начале апреля. Обертка FO-WLP дает возможность выпустить не менее узкие микропроцессоры, что позволит ещё несколько уменьшить толщину телефонов. При этом микропроцессоры приобретают вероятность ответвлять больше тепла и работать стремительней. Это добивается за счёт того, что площадь контактов в случае упаковки FO-WLP далеко выходит за границы кристалла микропроцессора, повышая этим самым площадь рассеивания тепла.
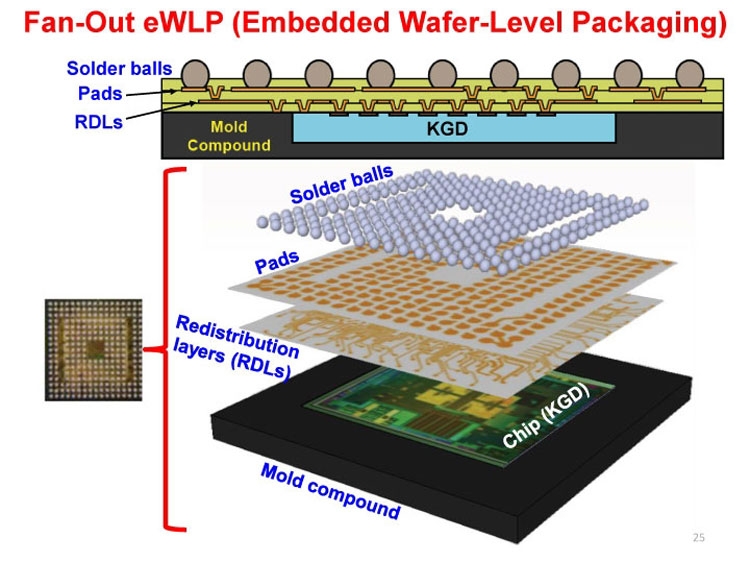
Образец упаковки FO-WLP (ASM Pacific Technology)
Иным плюсом упаковки FO-WLP является вероятность расположить в одном каркасе с микропроцессором разрывные и встроенные детали. Так, к примеру, в каркасе микропроцессор Эпл A10 для Айфон 7 гарантируют поместиться коммутаторы антенн, которые прежде занимали место на печатной плате. По сей день такие решения могла посоветовать лишь тайваньская организация TSMC. Компании «Самсунг» оставалось или отказаться от работы по заявкам Эпл, или самой обучаться складывать чипсеты способом FO-WLP. И она обучилась это делать.

По сведениям китайских источников, организация «Самсунг» закончила подготовки техпроцесса для упаковки чипов способом FO-WLP. Благодаря поступательной упаковке толщину микросхемы (микропроцессора Эпл A10) можно снизить приблизительно на 0,3 миллиметров. Представляется, что это несколько, однако в комплекте с подъемом мощности и повышении действенности остывания всё месте позволит уменьшить толщину телефона. Узкие телефоны с экраном без рамки делаются популярными устройствами. И достаточно хорошо, что за счёт франтов и модниц прогресс в формировании области продолжает своё перемещение.


 Февраль 19th, 2022
Февраль 19th, 2022  raven000
raven000  Опубликовано в рубрике
Опубликовано в рубрике